隨 著微電子技術的飛速發展,大規模和超大規模集成電路的廣泛應用,微組裝技術的進步,使印制電路板的制造向著積層化、多功能化方向發展,使印制電路圖形導線 細、微孔化窄間距化,加工中所采用的機械方式鉆孔工藝技術已不能滿足要求而迅速發展起來的一種新型的微孔加工方式即激光鉆孔技術。
一 激光成孔的原理
激光是當“射線”受到外來的刺激而增加能量下所激發的一種強力光束,其中紅外光和可見光具有熱能,紫外光另具有光學能。此種類型的光射到工件的表面時會發生三種現象即反射、吸收和穿透。
透過光學另件擊打在基材上激光光點,其組成有多種模式,與被照點會產生三種反應。
激光鉆孔的主要作用就是能夠很快地除去所要加工的基板材料,它主要靠光熱燒蝕和光化學燒蝕或稱之謂切除。
(1)光熱燒蝕:指被加工的材料吸收高能量的激光,在極短的時間加熱到熔化并被蒸發掉的成孔原理。此種工藝方法在基板材料受到高能量的作用下,在所形成的孔壁上有燒黑的炭化殘渣,孔化前必須進行清理。
(2)光化學燒蝕:是指紫外線區所具有的高光子能量(超過2eV電子伏特)、激光波長超過400納 米的高能量光子起作用的結果。而這種高能量的光子能破壞有機材料的長分子鏈,成為更小的微粒,而其能量大于原分子,極力從中逸出,在外力的掐吸情況之下, 使基板材料被快速除去而形成微孔。因此種類型的工藝方法,不含有熱燒,也就不會產生炭化現象。所以,孔化前清理就非常簡單。
以上就是激光成孔的基本原理。目前最常用的有兩種激光鉆孔方式:印制電路板鉆孔用的激光器主要有RF激發的CO2氣體激光器和UV固態Nd:YAG激光器。
(3)關于基板吸光度:激光成功率的高低與基板材料的吸光率有著直接的關系。印制電路板是由銅箔與玻璃布和樹脂組合而成,此三種材料的吸光度也因波長不同有所不同但其中銅箔與玻璃布在紫外光0.3mμ以下區域的吸收率較高,但進入可見光與IR后卻大幅度滑落。有機樹脂材料則在三段光譜中,都能維持相當高的吸收率。這就是樹脂材料所具有的特性,是激光鉆孔工藝流行的基礎。
二 CO2激光成孔的不同的工藝方法
CO2激 光成孔的鉆孔方法主要有直接成孔法和敷形掩膜成孔法兩種。所謂直接成孔工藝方法就是把激光光束經設備主控系統將光束的直徑調制到與被加工印制電路板上的孔 直徑相同,在沒有銅箔的絕緣介質表面上直接進行成孔加工。敷形掩膜工藝方法就是在印制板的表面涂覆一層專用的掩膜,采用常規的工藝方法經曝光/顯影/蝕刻工藝去掉孔表面的銅箔面形成的敷形窗口。然后采用大于孔徑的激光束照射這些孔,切除暴露的介質層樹脂。現分別介紹如下:
(1)開銅窗法:
首先在內層板上復壓一層RCC(涂樹脂銅箔)通過光化學方法制成窗口,然后進行蝕刻露出樹脂,再采用激光燒除窗口內基板材料即形成微盲孔:
當光束經增強后通過光圈到達兩組電流計式的微動反射掃描鏡,并經一次垂直對正(Fθ透鏡)而達到可進行激動的臺面的管區,然后再逐一燒成微盲孔。
在一英寸見方的小管區內經電子快束這定位后,對#p#分頁標題#e#0.15mm的盲孔可連打三槍成孔。其中第一槍的脈沖寬度約為15μs,此時提供能量達到成孔的目的。后再槍則利用來清理孔壁孔底的殘渣和修正孔。
激光能量控制良好的0.15mm微盲孔的SEM橫斷面及45度的全圖,此種開窗口的成孔工藝方法,當底墊(靶標盤)不大時又需大排版或二階盲孔時,其對準度就比較困難。
(2)開大窗口工藝方法:
前 一種工藝方法成孔的直徑與所開的銅窗口相同,如果操作稍有不慎就會使所開窗口的位置產生偏差,導致成孔的盲孔位置走位致使與底墊中心失準的問題產生。該銅 窗口的偏差產生的原因有可能是基板材料漲縮和圖像轉移所采用的底片變形有關。所以采取開大銅窗口的工藝方法,就是將銅窗口直徑擴大到比底墊還大經 0.05mm左右(通常按照孔徑的大小來確定,當孔徑為0.15mm時,底墊直徑應在0.25mm左右,其大窗口直徑為0.30mm)然 后再進行激光鉆孔,即可燒出位置精確對準底墊的微盲孔。其主要特點是選擇自由度大,進行激光鉆孔時可選擇另按內層底墊的程式去成孔。這就有效的避免由于銅 窗口直徑與成孔直徑相同時造成的偏位而使激光點無法對正窗口,使批量大的大拚板面上會出現許多不完整的半孔或殘孔的現象。
(3)樹脂表面直接成孔工藝方法
采用激光成孔有幾種類型的工藝方法進行激光鉆孔:
A.基板是采用在內層板上層壓涂樹脂銅箔,然后將銅箔全部蝕刻去掉,就可采用CO2激光在裸露的樹脂表面直接成孔,再繼續按照鍍覆孔工藝方法進行孔化處理。
B.基板是采用FR-4半固化片和銅箔以代替涂樹脂銅箔的相類似制作工藝方法。
C.涂布感光樹脂后續層壓銅箔的工藝方法制作。
D.采用干膜作介質層與銅箔的壓貼工藝方法制作。
E.涂布其它類型的溫膜與銅箔覆壓的工藝方法來制作。
(4)采用超薄銅箔的直接燒蝕的工藝方法
內層芯板兩面壓貼涂樹脂銅箔后,可采用“半蝕方法”將銅箔厚度17m經蝕刻后減薄到5微米,然后進行黑氧化處理,就可采用CO2激光成孔。
其基本原理就是經氧化處理成黑的表面會強烈吸光,就會在提高CO2激光的光束能量的前提下,就可以直接在超薄銅箔與樹脂表面成孔。但最困難的就是如何確保 “半蝕方法”能否獲得厚度均勻一致的銅層,所以制作起來要特別注視。當然可采用背銅式可撕性材料(UTC),銅箔相當簿約5微米。
根據這種類型的板加工,目前在工藝上主要采取以下幾個方面:
這主要對材料供應商提出嚴格的質量和技術指標,要確保介質層的厚度的差異在510μm之間。因為只有確保涂樹脂銅箔基材的介質厚度的均勻性,在同樣的激光能量的作用下,才能確保孔型的準確性和孔底部的干凈。同時還需要在后續工序中,采用最佳的除鉆污工藝條件,確保激光成孔后盲孔底部的干凈無殘留物。對盲孔化學鍍和電鍍層的質量會產生良好的作用。
轉載請注明出處。









 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀






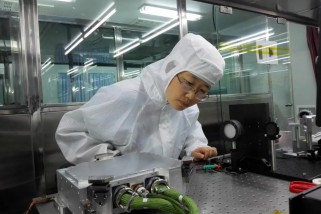

















 關注我們
關注我們




