內存容量更大、尺寸更小
最近幾年,SD和microSD內存卡的容量穩步提升,這些卡的物理尺寸和形狀還可以保持不變。而且,每兆字節(MB)單位成本顯著下降。上述進步的主要原因在于:第一,顯微光刻法的發展帶來的電路密度提高;第二,使用物理上更薄的晶圓,從而能夠在同樣封裝尺寸中垂直疊放更多晶圓。
現在,內存晶圓厚度通常為80微米或更薄,50微米是尖端技術,而20微米晶圓還處于研發層面。從規模經濟考慮,這些晶圓的直徑能達到300毫米。硅是一種晶體材料,因此一塊300毫米×50微米的晶圓是非常易碎的,機械接觸很容易讓晶圓開裂和破損。而且,后處理費用通常大大高于10萬美元,因此必須在單切工藝中避免破損。

圖 3
傳統上,使用鉆石圓鋸旋轉進行的單切將會重復多次。然而如果晶圓厚度為80微米,圓鋸必須放慢到很不經濟的旋轉速度,降低切割壓力以避免剝落、開裂和破損(見圖3)。這給激光器創造了巨大的機會。現在許多芯片生產商已經轉而使用355納米調Q半導體泵浦固體激光器。與圓鋸類似,激光切割必須采用多程,以最大限度減少需要后處理才能消除的熱損傷。因此,唯一最重要的激光參數是極高的脈沖重復頻率。更為特別的是,掃描速度通常為600到750毫米/秒,這樣才能在做5程左右處理時讓總切割速度達到150毫米/秒。這種應用還要求非常高的邊緣質量,所以要有50%的脈沖波動空間疊加。因此,針對這種薄晶圓應用,Coherent公司開發了一款脈沖重復頻率極高的激光器(AVIA 355-23-250),脈沖重復頻率為250千赫,輸出功率大于8瓦,能夠為單程提供充足的切割能量。另外,對于在工藝過程開發中使用混合皮秒級激光器的興趣與日俱增,原因在于更短的脈沖持續時間產生的熱影響區(HAZ)更小,從而能夠避免后處理。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀




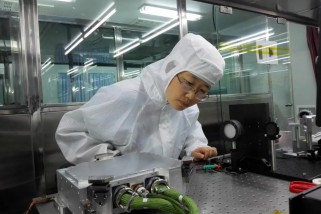






















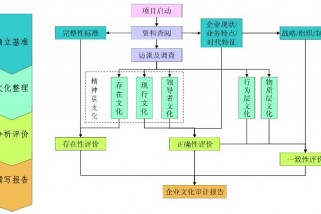





 關注我們
關注我們




