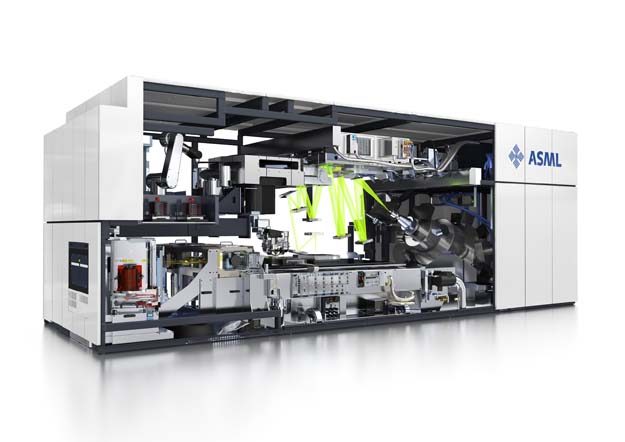
圖1:ASML前期制作掃描儀——雙子掃描NXE:3100
極紫外(EUV)光刻的研究已經已經超過20年了,在所有尚未解決的技術難題中,最大的難題是如何產生適用的光線。過去很長一段時間里,一些研究者曾嚴重懷疑250瓦的大批量制造的目標究竟能否達到,然而現(xiàn)在這個目標已經實現(xiàn)了。怎么做到的?當然是通過對每個微小細節(jié)一絲不茍的研究。不久前,關于極紫外光刻是否運用到工業(yè)芯片制造中還是個飽受爭議的問題。“我們發(fā)現(xiàn)EUV光源問題比我們以前想得要難得多,”奧巴尼亞(美國)Sematech的光刻主管斯特凡吳在2013的LFW文章中說道。而在2014年,ASML/Cymer的研發(fā)團隊首次證明了250瓦紫外光刻的可行性。當Trumpf集團在2015年宣布投資8千萬美元到一個新的EUV泵激光器工廠中的時候,研究者對這項技術的信心更加堅定了。
今年,ASML和Trumpf極紫外光刻方面的銷售創(chuàng)了紀錄。經過多年來的大量的研發(fā)投入,像英特爾、三星、臺積電、IBM和格羅方德這樣的工業(yè)巨頭把EUV納入未來兩年為7納米節(jié)點推出的藍圖。三星對此已經制定好了計劃,而其他比如像羅格方德宣布在大批量制造技術成熟時會轉移到EUV領域。
激光系統(tǒng)
ASML/Cymer團隊在近期文章中概述了了關于他們EUV光源的大批量制造的工作。他們表示對于占空比60%的典型掃描儀,每小時100個晶片的產量,晶片的功率應該超過約550mW。這意味著EUV光源提供在中間焦點的曝光設備的能量應該大于200瓦。
在13.5nm的波長產生200W的功率可以選擇的方法是在微小的錫滴上燒制CO2激光。激光蒸發(fā)錫然后產生一個發(fā)射非相干輻射到一個實心的球體的等離子體。在中間焦點的功率描繪了可用于照亮半導體的會聚光器件后面的光。
目前的挑戰(zhàn)是非常之多的,簡單舉幾個例子:穩(wěn)定性、碎片減緩、功率調節(jié)、轉換效率等,上述例子中最后兩個對于200瓦的大批量制造的目標是最重要的因素。經管Trumpf早已擁有用來切割和焊接的千瓦級CO2激光器,他們也得完全重新考慮他們激光系統(tǒng)產生EUV的問題。
由于二氧化碳輻射到EUV的轉換效率為百分之幾,二氧化碳源必須提供20 kW以上的功率的能源。輻射以50kHz的脈沖碰撞~30 µm的錫滴。對于升級過的效率轉換最重要的是激光器必須有一個特殊預脈沖。在測試了幾組不同設定的方案后,團隊用雙子掃描NXE:3100系統(tǒng)達到了三級功率放大(+預放大),如圖1所示。
預脈沖頻率正確才能成功
在激光科學研究的早期,科學家們就早已開始研究激光產生等離子。之后很快,科學家就清楚了預脈沖可以極大提高激光轉變?yōu)榈入x子輻射的轉換效率,科學家從1970年就在理論上和實驗上對這種能量轉換的效果開始了刻苦的鉆研。EUV的研發(fā)團隊曾必須近距離觀察激光產生等離子的實驗,不僅僅是為了更進一步達到大批量制造的目標,也為了解決一個經濟議題:每一個百分點的轉換效率的提高將為消費者節(jié)省數百萬的投資。
圖二展示了預脈沖技術的進化所取得的令人驚嘆的進步。預脈沖蒸發(fā)了錫滴,將其轉化為一個擁有完美形態(tài)和密度的目標。實際上,目標直徑早已被擴大到400µm,轉換效率提高到超過4%的盤形目標。在目標直徑處,激光束輪廓比明顯小于光束尺寸的液滴初始尺寸更好用。
如研究人員論文報告所述,一臺經過改良的ASML NXE:3300B激光器在15年末和16年初展示了持續(xù)一個小時的EUV功率控制,功率為210瓦,這個突破性成果也第一次闡明了以激光為光源的EUV滿足大批量制造的能力。
同時,ASML/Cymer的作者稱超過十個他們的EUV激光光源器已經在全世界范圍被投入使用,積累必要的經驗知識來最終使其技術能做到大批量制造。MOPA(主控振蕩器的功率放大器)預脈沖技術已經被確認為提高功率輸出的正確方式,以及在中間焦點建立了把功率穩(wěn)定在210瓦的機制。具有> 5 sr光收集和高平均反射率的正常入射收集器反射體目前已經開始批量生產,并且在該領域中使用壽命越來越長。NXE 3350B上增強的集電極保護和原位清洗技術預計將進一步延長使用壽命, NXE 3400B于2017年在客戶的設施中安裝。
在Semicon West 2017上,ASML團隊聲稱“通過真正理解光源的轉換效率和并將合適的控制置于合理的位置”,250瓦的功率可以持續(xù)的保持。

圖二:不同目標形狀和密度的轉換效率
轉載請注明出處。









 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀






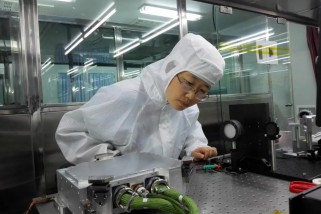

















 關注我們
關注我們




