關于
激光器
晶圓切割問題,
在上次的基礎上補充一些內容,大家建議取消文章收費設置,本主覺得有道理,以后發文均不收費了。
這是一篇關于晶圓切割的問題,主要是我用到的GaAs晶圓,也可以應用到InP晶圓等等需要晶面的晶圓上,供大家借鑒。
如下圖,dies從wafer上切割下來,才能進行下一步的封裝,切割線在設計晶圓的時候都有考量。

1 晶圓切割
晶圓切割的方法有許多種,常見的有砂輪切割,比如disco的設備;
激光切割
、劃刀劈裂法,也有金剛線切割等等。


這個就是砂輪切割,一般就是切穿晶圓,刀片根據產品選擇,有鋼刀、樹脂刀等等。

但是對于
激光
器芯片來說不能進行激光或者刀片這些直接物理作用的方法進行切割。

比如GaAs或者Inp體系的晶圓,做側發光激光時,需要用到芯片的前后腔面,因此端面必須保持光滑,不能有缺陷。切GaAs、InP材質具有解離晶面,沿此晶面,自動解離出光滑的晶向面,對發光效率等影響很大。

因此常用先正面劃開一個豁口,然后用劈刀頂開自動劈裂。

同時要保證劈裂方向是完全沿著晶向方向劈開的,如上圖a,如果劈裂斜了就可能出現b的現象。
2 激光晶圓切割
1. 晶圓減薄

晶圓減薄至150~100um的厚度,太厚很難切開,由于硬度問題且不一定會沿著晶向方向。一般激光器的晶圓也需要薄一些,太厚體電阻太大。
2. 貼到專用的藍膜治具上

3. 沿著紅線劃成一個一個的小塊,也叫cell,采用的時候金剛石劃刀

4. 劃完之后,采用劈裂機劈開。cell就解離出來了。

5. 取出cell單元,進一步切成bar條,黃色的線就表示一根bar條,分別在紅色前后兩端劃出一小段溝槽即可。

6. 劃完之后,采用劈裂機劈開,藍膜在上,cell在下,從上往下劈,紅色是預先劃的溝槽,由于力的作用,都會先從溝槽開始劈裂。


7. 劈成bar條之后,由于左右兩邊有一部分被劃傷,是不能用作有效芯片的,因此后期這一部分會被舍掉。因而這一段距離的芯片通常會做一些其他方面的設計,比如測試電極啊,bar條或者chip命名什么的。


到這一步,有的bar條直接拿去測試了。
8. bar條分成chip

9. 方法同上,也是先劃,后劈,但是激光器側邊不像前后出光反射面,不需要保持晶向劈裂,因此可以從頭劃到尾。


劈裂完成之后,進行擴膜,一顆一顆的芯片就ok了。
轉載請注明出處。









 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀






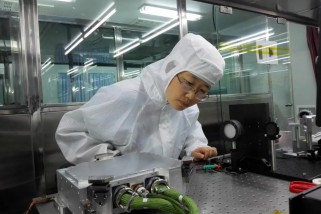


















 關注我們
關注我們




